Ionska implantacija je niskotemperaturni proces kojim se komponente jednog elementa ubrzavaju u čvrstu površinu ploče, čime se mijenjaju njegova fizička, hemijska ili električna svojstva. Ova metoda se koristi u proizvodnji poluvodičkih uređaja i u završnoj obradi metala, kao i u istraživanju nauke o materijalima. Komponente mogu promijeniti elementarni sastav ploče ako se zaustave i ostanu u njoj. Implantacija iona također uzrokuje hemijske i fizičke promjene kada se atomi sudare s metom pri visokoj energiji. Kristalna struktura ploče može biti oštećena ili čak uništena energetskim kaskadama sudara, a čestice dovoljno visoke energije (10 MeV) mogu prouzrokovati nuklearnu transmutaciju.
Opšti princip ugradnje jonske implantacije

Oprema se obično sastoji od izvora u kojem se formiraju atomi željenog elementa, akceleratora u kojem se elektrostatički ubrzavaju do visoke energije i ciljne komore u kojoj se sudaraju s metom, koja je materijal. Dakle, ovaj proces je poseban slučaj zračenja čestica. Svaki ion je obično zaseban atom ili molekul, pa je stvarna količina materijala implantiranog u cilj vremenski integral jonske struje. Ovaj broj se zove doza. Struje koje unose implantati obično su male (mikroampere), pa je stoga količina koja se može implantirati u razumnom roku mala. Stoga implantacija iona nalazi primjenu u slučajevima kada je broj potrebnih hemijskih promjena mali.
Tipične ionske energije kreću se od 10 do 500 keV (1600 do 80.000 AJ). Ionska implantacija se može koristiti pri niskim energijama u rasponu od 1 do 10 keV (160 do 1600 AJ), ali penetracija je samo nekoliko nanometara ili manje. Snaga ispod ovoga dovodi do veoma manjih oštećenja mete i pada pod oznakom od taloženja Jonskog snopa. I veće energije se takođe mogu koristiti: akceleratori sposobni za 5 MeV (800.000 AJ) su uobičajeni. Međutim, često postoji velika strukturna oštećenja cilja, a budući da je raspodjela dubine široka (Bragg peak), neto promjena sastava u bilo kojoj tački mete bit će mala.
Energija jona, kao i različite vrste atoma i sastav cilja određuju dubinu prodora čestica u čvrstu materiju. Snop monoenergetskih jona obično ima široku distribuciju dubine. Prosječna penetracija se zove raspon. U tipičnim uslovima biće između 10 nanometara i 1 mikrometra. Stoga je niskoenergetska ionska implantacija posebno korisna u slučajevima kada je poželjno da hemijska ili strukturna promjena bude blizu ciljne površine. Čestice postepeno gube energiju prilikom prolaska kroz čvrstu materiju, kako od slučajnih sudara sa ciljnim atomima (koji uzrokuju nagli prenos energije), tako i od laganog kočenja zbog preklapanja elektronskih orbitala, što je kontinuiran proces. Gubitak ionske energije u meti naziva se zaustavljanje i može se modelirati metodom implantacije iona u aproksimaciji binarnog sudara.
Sistemi akceleratora se obično dijele na srednje strujne, visoke, visoke energije i vrlo značajne doze.
Sve vrste dizajna greda za implantaciju iona sadrže određene zajedničke grupe funkcionalnih komponenti. Pogledajmo primjere. Prve fizičke i fizičko-hemijske osnove implantacije iona uključuju uređaj poznat kao izvor za stvaranje čestica. Ovaj uređaj je usko povezan sa ofset elektrodama za ekstrakciju atoma u liniju snopa i najčešće nekim sredstvima za odabir određenih tipova za transport do glavnog dijela akceleratora. Izbor "mase" često je praćen prolazom povučenog Jonskog snopa kroz područje magnetnog polja sa izlaznom stazom ograničenom blokiranjem rupa ili "proreza" koji omogućavaju samo Jone sa određenom vrijednošću proizvoda mase i brzine. Ako je ciljna površina veća od prečnika Jonskog snopa i implantirana doza je poželjno ravnomerno raspoređena po njoj, onda se koristi neka kombinacija skeniranja snopa i kretanja ploče. Konačno, cilj je povezan na neki način prikupljanja akumuliranog naboja implantiranih jona, tako da se isporučena doza može kontinuirano mjeriti i proces se zaustavlja na željenom nivou.
Primjena u proizvodnji poluprovodničkih uređaja
Doping sa Borom, fosforom ili arsenom je uobičajena primena ovog procesa. Tokom ionske implantacije poluprovodnika, svaki atom dopanta može stvoriti nosač naboja nakon žarenja. Moguće je izgraditi rupu za dopant p-tipa i elektron n-tipa. Ovo mijenja provodljivost poluprovodnika u njegova blizina. Tehnika se koristi, na primjer, za podešavanje praga MOSFETA.
Ionska implantacija razvijena je kao metoda za dobijanje pn spoja fotonaponskih uređaja kasnih 1970 - ih i ranih 1980-ih, zajedno sa upotrebom impulsnog elektronskog snopa za brzo žarenje, iako do danas nije korištena za komercijalnu proizvodnju.
Silicon on izolator

Jedna od poznatih metoda dobijanja ovog materijala na dielektričnim supstratima (SOI) iz konvencionalnih silicijumskih supstrata je SIMOX proces (odvajanje implantacijom kiseonika), u kojem se ispunjeni vazduh sa visokom dozom pretvara u silicijum oksid zbog procesa visokotemperaturnog žarenja.
Mezotaksija
To je termin za rast kristalografski podudarne faze ispod površine glavnog kristala. U ovom procesu, joni se implantiraju sa dovoljno visokom energijom i dozom u materijal da bi se stvorio sloj druge faze, a temperatura se podešava tako da se struktura mete ne uništi. Kristalna orijentacija sloja može biti dizajnirana tako da odgovara svrsi, čak i ako tačna konstanta rešetke može uvelike varirati. Na primer, nakon implantacije nikl jona u silicijumsku pločicu, može se uzgajati sloj silicida u kojem se orijentacija kristala poklapa sa vrednostima silicijuma.
Primjena u završnoj obradi metala

Azot ili drugi joni mogu se implantirati u metu od alatnog čelika(npr. Strukturna promjena izaziva kompresiju površine u materijalu, što sprečava širenje pukotina i na taj način ga čini otpornijim na uništavanje.
Površinska obrada

U nekim primenama, na primer za proteze kao što su veštački zglobovi, poželjno je imati metu koja je veoma otporna i na hemijsku koroziju i na habanje usled trenja. Ionska implantacija koristi se za dizajn površina takvih uređaja za više pouzdan rad. Kao i u slučaju alatnih čelika, modifikacija cilja uzrokovana implantacijom iona uključuje i površinsku kompresiju, koja sprečava širenje pukotina, i legiranje kako bi bila hemijski otpornija na koroziju.
Ostale aplikacije

Implantacija se može koristiti za postizanje miješanja jonskih zraka, odnosno miješanja atoma različitih elemenata na interfejsu. Ovo može budi koristan za postizanje stepenastih površina ili poboljšanje prianjanja između slojeva materijala koji se ne miješaju.
Formiranje nanočestica
Implantacija iona može se koristiti za indukciju materijala nanorazmjera u oksidima kao što su safir i silicijum dioksid. Atomi se mogu formirati kao rezultat padavina ili stvaranja mješovitih supstanci koje sadrže i Jonsko implantirani element i supstrat.
Tipična energija Jonskog snopa koja se koristi za proizvodnju nanočestica kreće se od 50 do 150 keV, a ionska tečnost se kreće od 10-16 do 10-18 kv. cm. . Širok izbor materijala veličine od 1 nm do 20 nm i sa kompozicijama koje mogu sadržavati implantirane čestice, kombinacije koje se sastoje isključivo od kationa mogu se formirati povezane sa supstratom.
Obećavaju supstance na bazi dielektrika, kao što je safir, koje sadrže dispergovane nanočestice jonske implantacije metala materijali za optoelektronika i nelinearna optika.
Problemi
Svaki pojedinačni ion proizvodi mnogo tačkastih defekata u ciljnom kristalu kada se udari ili ugradi. Slobodna radna mjesta su rešetkaste tačke koje ne zauzima atom: u ovom slučaju, Jon se sudara sa ciljnim atomom, što dovodi do prijenosa značajne količine energije na njega, tako da napušta svoje mjesto. Ovaj ciljni objekt sam po sebi postaje projektil u čvrstom stanju i može uzrokovati uzastopne sudare. Internodije se javljaju kada se takve čestice zaustave u čvrstoj tvari, ali ne nalaze slobodan prostor u rešetki za život. Ovi tačkasti defekti tokom implantacije iona mogu migrirati i Grupirati jedni s drugima, što dovodi do stvaranja dislokacijskih petlji i drugih problema.
Amorfizacija
Količina kristalografskog oštećenja može biti dovoljna za potpuni prijelaz ciljne površine, odnosno trebala bi postati amorfna čvrsta supstanca. U nekim slučajevima, potpuna amorfizacija mete je poželjnija od kristala sa visokim stepenom defekta: takav film može ponovo rasti na nižoj temperaturi nego što je potrebno za žarenje teško oštećenog kristala. Amorfizacija podloge može nastati kao rezultat promjene grede. Naprimjer, kada se ioni itrija implantiraju u safir sa energijom snopa od 150 keV do tečnosti od 5*10-16 Y + / sq. cm, formira se staklasti sloj debljine približno 110 nm, mjeren sa vanjske površine.
Prskanje

Neki od događaja sudara uzrokuju izbacivanje atoma sa površine, pa će implantacija iona polako nagrizati površinu. Efekat je primetan samo kod veoma velikih doza.
Jonski kanal

Ako se kristalografska struktura primijeni na cilj, posebno u poluvodičkim supstratima, gdje je otvorenija, tada se određeni smjerovi zaustavljaju mnogo manje od ostalih. Rezultat je da radijus djelovanja iona može biti mnogo veći ako se kreće tačno određenom putanjom, na primjer u silicijumu i drugim kubnim dijamantskim materijalima. Ovaj efekat se naziva Jonsko kanalisanje i, kao i svi slični efekti, visoko je nelinearan, sa malim odstupanjima od idealne orijentacije, što dovodi do značajnih razlika u dubini implantacije. Iz tog razloga, većina se izvodi nekoliko stepeni izvan ose, gdje će male greške u poravnanju imati predvidljivije efekte.
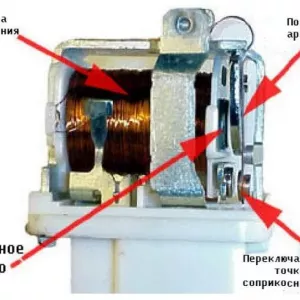 Dajte: vrste, klasifikacija, svrha i princip rada
Dajte: vrste, klasifikacija, svrha i princip rada Princip rada destilatora, vrste, primjena
Princip rada destilatora, vrste, primjena Drenaža zemljišta: pojam, svrha, metode i metode rada
Drenaža zemljišta: pojam, svrha, metode i metode rada Dac circuit. Digitalni-analogni pretvarači: vrste, klasifikacija, princip rada, namjena
Dac circuit. Digitalni-analogni pretvarači: vrste, klasifikacija, princip rada, namjena Kako koristiti vpn: princip rada, kako omogućiti i izabrati pregledač
Kako koristiti vpn: princip rada, kako omogućiti i izabrati pregledač Tunelski mikroskop: istorija stvaranja, uređaj i princip rada
Tunelski mikroskop: istorija stvaranja, uređaj i princip rada Luxmeter - šta je to: uređaj, vrste i princip rada
Luxmeter - šta je to: uređaj, vrste i princip rada Peć za proizvodnju lučnih čelika: uređaj, princip rada, snaga, sistem upravljanja
Peć za proizvodnju lučnih čelika: uređaj, princip rada, snaga, sistem upravljanja Uređaj za uvlačenje antene: princip rada
Uređaj za uvlačenje antene: princip rada